Reaktiv -ion etsning - Reactive-ion etching
Reactive-ion etching ( RIE ) er en etsningsteknologi som brukes i mikrofabrikasjon . RIE er en type tørretsing som har andre egenskaper enn våtetsing . RIE bruker kjemisk reaktivt plasma for å fjerne materiale som er avsatt på skiver . Plasmaet genereres under lavt trykk ( vakuum ) av et elektromagnetisk felt . Høy energi ioner fra plasmaet angripe skivens overflate og reagere med den.
Utstyr
Et typisk (parallelt plate) RIE -system består av et sylindrisk vakuumkammer, med et skivefat plassert i den nedre delen av kammeret. Platen er isolert elektrisk fra resten av kammeret. Gass kommer inn gjennom små innløp i toppen av kammeret, og kommer ut til vakuumpumpesystemet gjennom bunnen. Typene og mengden gass som brukes varierer avhengig av etseprosessen; for eksempel er svovelheksafluorid ofte brukt for etsning av silisium . Gasstrykket opprettholdes vanligvis i et område mellom noen få milli torr og noen få hundre millitorr ved å justere gassens strømningshastigheter og/eller justere en eksosåpning.
Andre typer RIE -systemer finnes, inkludert induktivt koblet plasma (ICP) RIE. I denne typen systemer genereres plasmaet med et RF -drevet magnetfelt. Svært høye plasmatettheter kan oppnås, selv om etseprofiler pleier å være mer isotrope.
En kombinasjon av parallell plate og induktivt koblet plasma RIE er mulig. I dette systemet brukes ICP som en høy tetthetskilde for ioner som øker etsingshastigheten, mens en separat RF -forspenning påføres substratet (silisiumskive) for å lage retningsbestemte elektriske felt nær substratet for å oppnå flere anisotrope etseprofiler.
Driftsmetode
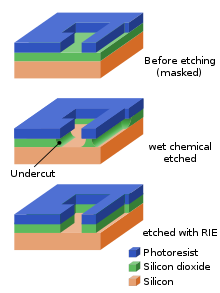
Plasma initieres i systemet ved å bruke et sterkt RF ( radiofrekvens ) elektromagnetisk felt på waferfatet. Feltet er vanligvis satt til en frekvens på 13,56 Megahertz , påført på noen få hundre watt . Det oscillerende elektriske feltet ioniserer gassmolekylene ved å fjerne dem fra elektroner og danne et plasma .
I hver syklus i feltet blir elektronene akselerert elektrisk opp og ned i kammeret, og noen ganger treffer både den øvre veggen i kammeret og waferfatet. Samtidig beveger de mye mer massive ionene seg relativt lite som svar på det elektriske RF -feltet. Når elektroner absorberes i kammerveggene mates de rett og slett ut til bakken og endrer ikke den elektroniske tilstanden til systemet. Imidlertid forårsaker elektroner som er avsatt på wafer -tallerkenen at tallerkenen bygger opp ladning på grunn av dens DC -isolasjon. Denne ladningsoppbyggingen utvikler en stor negativ spenning på fatet, vanligvis rundt noen få hundre volt. Plasmaet i seg selv utvikler en litt positiv ladning på grunn av den høyere konsentrasjonen av positive ioner sammenlignet med frie elektroner.
På grunn av den store spenningsforskjellen har de positive ionene en tendens til å drive mot waferfatet, hvor de kolliderer med prøvene som skal etses. Ionene reagerer kjemisk med materialene på overflaten av prøvene, men kan også slå av ( sprute ) noe materiale ved å overføre noe av kinetisk energi . På grunn av den hovedsakelig vertikale avgivelsen av reaktive ioner, kan reaktiv-ion-etsing produsere svært anisotrope etseprofiler, som står i kontrast til de typisk isotropiske profilene for våt kjemisk etsing .
Etseforhold i et RIE -system avhenger sterkt av de mange prosessparametrene, for eksempel trykk, gassstrømmer og RF -effekt. En modifisert versjon av RIE er dyp reaktiv-etsning , som brukes til å grave ut dype trekk.
Se også
- Deep RIE (Bosch Process)
- Plasma etser